【01】背景介绍
电子信息产业的高速创新带动了微电子器件向小型化、集成化方向发展,由此产生的热点和电子器件的热失效引起了广泛的关注。高效的热能管理系统是保证大功率电子设备稳定、安全运行的关键。电子封装材料是集成电子产品的一个组成部分,通常使用廉价,易于加工,耐腐蚀的聚合物材料。然而,大多数聚合物的固有热导率非常低(0.1-0.3W/m·K),这严重限制了电子封装材料在电子器件热管理中的有效使用。
因此,开发高导热聚合物基电子封装材料是电子热管理的重要组成部分。一般来说,提高聚合物导热性的有效方法是填充高导热填料,如石墨烯、氮化硼和碳纳米管。其中,石墨烯以其超高的面内导热系数(3500-5300W/m·K)和优异的机械性能,彻底改变了导热材料领域。在过去的几十年里,石墨烯经常被用作分散填料来增强聚合物的导热性。然而,填料与填料之间以及填料与聚合物之间较大的界面热阻严重限制了聚合物内部有效声子输运途径的形成。因此,这需要较大质量分数的填料来获得有效的导热性增强,分散的填料在聚合物内部产生更多的界面,使聚合物的机械性能更糟。
近年来,预先构建相互连接的三维(3D)石墨烯框架,然后对聚合物进行回填被证明是一种非常有效的方法,可以制造具有改进性能的聚合物复合材料预成型的石墨烯框架为聚合物中的声子提供了一个完整而有效的途径,在低石墨烯负载下实现了高导热性,并最大限度地保护了聚合物复合材料的机械性能。其中通过化学气相沉积(CVD)在制备更大体积的三维石墨烯网络方面受到限制,同时制备过程较为繁琐和昂贵,双向冷冻法对设备的要求较高,难以实现工业化生产。一般来说,在较低填料含量下实现高导热性增强仍然是一个关键问题。
【02】成果掠影

近日,昆明理工大学蔡晓明、蔡金明团队针对解决导热填料与导热性能、机械性能的协同调控取得最新进展。在聚合物中制备相互连接的石墨烯纳米片框架是一种有效的解决较低填料含量下实现高导热性增强的方法之一。然而,目前制备石墨烯纳米片框架的方法通常是复杂的,并且交联密度低。在此该文制备了具有高交联密度的高质量石墨烯纳米片框架。通过利用氧化石墨烯自组装的特性,利用冰模板法制备了三维交联氧化石墨烯气凝胶(GOA)。经过3000℃高温处理,得到了导热系数高、力学性能优异的石墨化石墨烯气凝胶(GGA)。对GGA进行不同程度的压缩,然后用环氧树脂渗透,得到一系列GGAx/环氧复合样品。当石墨烯含量仅为9wt%时,环氧复合材料的面内导热系数达到18.8W/m·K,导致每1wt%的石墨烯负载导热系数增强1034%,这优于聚合物声子通路中使用的大多数传统石墨烯网络结构。
本研究提供了一种制备高交联密度石墨烯纳米片框架的简便方法,对未来石墨烯纳米材料在电子封装散热方向的发展具有启发作用。研究成果以“Thermally Conductive Epoxy Resin Composites Based on 3D Graphene Nanosheet Networks for Electronic Package Heat Dissipation”为题发表在《ACS Applied Nano Materials》。

方案1. GOA和GGA的编制方案。
【03】图文导读
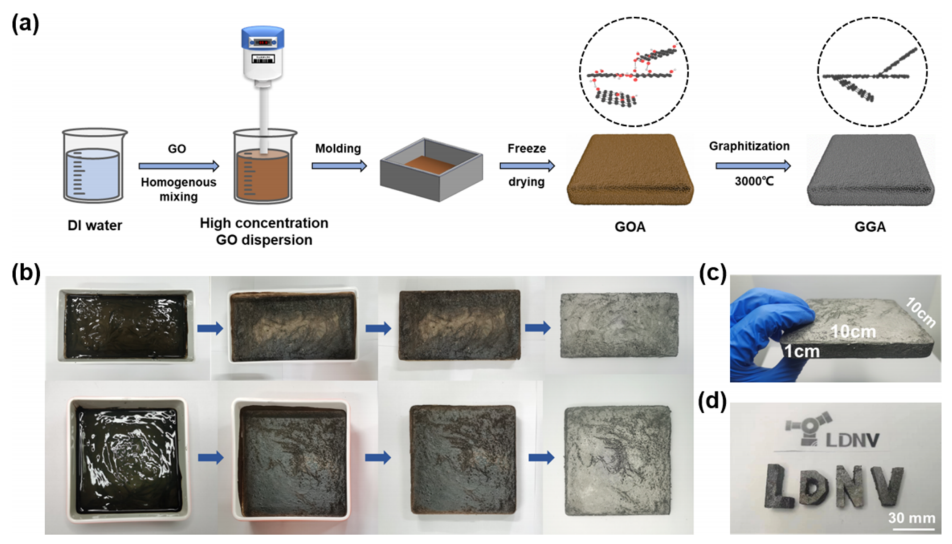
图1. (a)GOA和GGA的制作工艺示意图。(b)GGA样品的形状可以根据模具的形状来定制。(c)方形GGA样品的宏观尺寸。(d)GGA样品具有出色的可定制性。

图2. (a)GOA石墨化后的结构变化示意图。(b, c)GOA截面的SEM图像。(d, e)GGA截面的SEM图像。(f)GOA、CRGA和GGA的XRD谱图。(g)GOA、CRGA和GGA的拉曼光谱。(h)GOA、CRGA和GGA的XPS光谱。(i)GOA、CRGA和GGA的FTIR光谱。

图3. (a)GOA和GGA压缩回弹过程示意图及GGA力模型模拟。(b)GGA/环氧复合材料制备工艺示意图。(c)GGAx/epoxy系列作物种植后的样品。(d)GGA在20%、40%、60%和80%压缩应变下的压应力-应变曲线。(e)纯环氧树脂和GGAx/环氧树脂的抗压强度和压缩模量(f)。

图4. (a)GGA密度及其在复合材料中的含量随GGA压缩比的变化关系。(b)GGAx/环氧树脂的面内导热系数和透面导热系数随石墨烯含量的变化。(c)GGAx/环氧树脂的导热性增强(TCE)。(d)GGA压缩导致复合材料导热性增强的示意图。(e)GGA/环氧树脂截面的SEM图像。(f)GGA8/环氧树脂截面的SEM图像。(g)GGAx/环氧树脂样品在不同温度下的导热系数。(h)GGA8/环氧复合材料在多次加热和冷却循环时的导热系数。(i)导热系数与其他三维石墨烯基复合材料的比较。
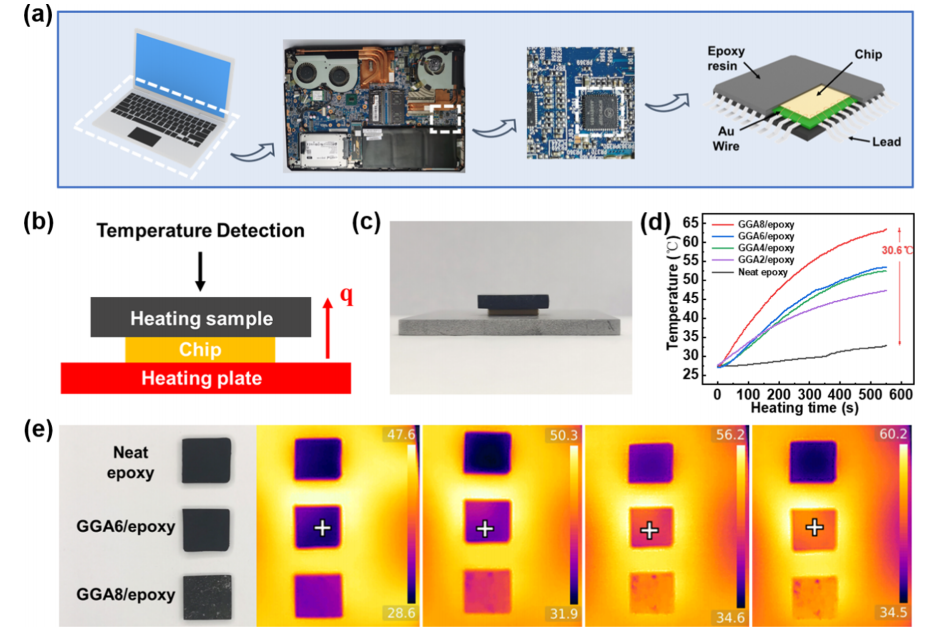
图5. (a)用于计算机芯片封装的环氧树脂示意图。(b)测试封装材料的传热能力配置和(c)其光学图像。(d)GGAx/环氧树脂样品和纯环氧树脂的升温曲线。(e)纯环氧树脂、GGA6/环氧树脂、GGA8/环氧树脂加热后的红外图像对比。
信息来源 | 洞见热管理
文章原文 | https://doi.org/10.1021/acsanm.4c01139
 粤公网安备 44190002005690号
粤公网安备 44190002005690号
